반도체 제조 공정 장비 운영
(9) Cleaning의 주요 공정
세정공정의 분류
1. 건식세정(Dry Cleaning)
2. 습식(Wet Cleaning)
- RCA 세정이 대표적: 과산화수소를 근간으로 함
- RCA Cleaning
SC1(Standard Cleaning-1): 암모니아 과산화수소, 물을 일정한 비율로 혼합하여 세정
SC2(Standard Cleaning-2): 염산, 과산화수소, 물을 일정한 비율로 혼합하여 세정,
HPM(Hydrochloric Peroxide Mixture)라고도부름.
대부분의 금속 오염물들은 희석 염산만으로도 제거가 가능하지만
전기음성도가 큰 귀금속(Noble Metal: Cu, Al)은 어렵기 때문에 염산과 과산화수소가 혼합된 세정용액으로 제거해야함
- Piranha Cleaning: 황산과 과산화수소 혼합
SPM(Sulfuric Peroxide Mixture)라고도 부름
유기오염물과 감광제 잔유물(PR Residue)을 제거하기 위해 사용하며
고온세정 과정 중 과산화수소가 분해되어 물을 형성함으로써 세정액의 농도를 희석시킴
-> 사용후 8~12시간이 지나면 더 이상 사용할 수 없음
-> 희석시킨 황산 내 오존을 주입하여 사용함
- 인산 세정
인산 용액 내의 수분 감소 -> 용액 농도 증가 -> 질화막의 식각율 감소, 산화막의 식각율 증가
-불산(HF)세정
산화막 식각에 사용되는 대표적인 세정액, 물에 희석시켜 사용, 상온 공정에서 사용.
다른 할로겐산에 비해 잘 해리가 되지 않음. -> 분자 상태로 있을때 가장 안정적임
BHF(Buffered HF): Buffered Oxide Etchant로, 흔히 BOE라고 부르며
HF에 NH₄F를 혼합시켜 사용하는 세정액. 파티클 제거에도 용이하며 불산에 비해 식각율도 높음
- 유기용제 세정
Metal Etch나 Via Etch후에 사용되는 세정 용액
유기용제에 특별한 기능을 가진 첨가물을 사용하여 Etch후에 발생되는 Polymer를 제거하는데
사용되는 용액. 주로 Corrosion 방지제, Polymer 용해제 등을 첨가함
- 초음파 세정
고주파의 초음파를 이용하여 물이나 용제를 진동시켜 세정
메가소닉 세정 -> 더욱 높은 1000kHZ대의 주파수 사용
비접촉 음파 에너지를 SC1이나 순수에 사용함.
-> 에칭공정 후에 발생하는 파티클을 제거하거나 CMP 공정 후 웨이퍼 표면에 잔류하는
오염 물질을 제거, 오염된 반도체 장비 부품을 세정하는데 사용됨
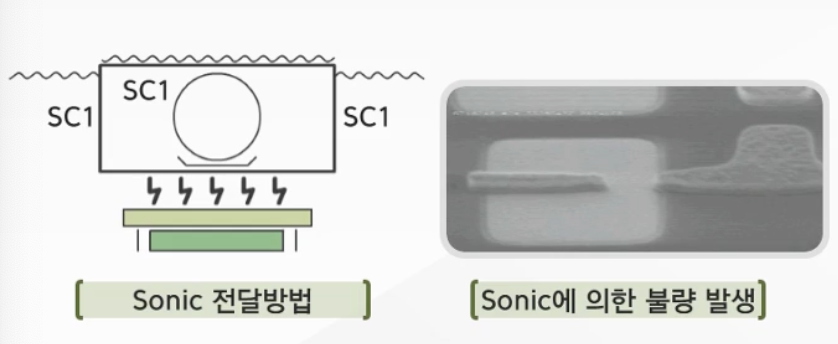
주파수에 따라 불량이 발생 가능하므로 주의.
3. 건조 (Dryer)
-Spin Dryer
Wafer가 회전을 하면서 약액을 처리하는 세정공정을 진행하고 이후에 DIW(De-ionized Water)를 이용해
세정을 하고 건조를 하는 방식
짧은 시간에 고속회전의 필요성이 있으며 최고 RPM은 3,000~4,000 정도의 회전 수를 가짐
처리하는 Wafer 수에 따라 Batch Type, Single Type으로 구분됨
장점: 가격 저렴, 유지관리 쉬움
단점: 회전 중 Wafer 파손의 위험, 단차가 있는곳의 건조가 불량해 물반점(Water Mark), Particl 발생 가능성
-IPA Dryer (Iso-Propyl Alcohol)
IPA Vapor를 이용해서 건조
IPA Vapor는 Cooling Coil에 의해 Vapor Zone에만 존재하며
Vapor Zone에서 일정시간 머무는 동안 DIW와 IPA Vapor가 서로 치환하게 됨
Cooling Zone 위로 Wafer가 올라오면 표면의 IPA가 휘발하게 되어 건조하는 방식
장점: Spin Dryer에 비해 상대적으로 Particle 발생이 적으며 다나가 있는 곳의 건조도 용이
단점: IPA 사용에 따른 유지비가 많이 들며 휘발성이 커 화재 위험성이 있음, Wafer에 IPA가 남을 수도 있음
- Marangoni Dryer
물과 IPA 간의 표면장력 차이에 의해 발생하는 마랑고니 현상을 이용, IPA Dryer 범주에 속함
<Marangoni Effect>
건조 효과가 있는 IPA층을 물 상층부에 주입시키면 밀도 차이에 의해 IPA가 물 위에 뜨게 됨
적당한 온도에서 웨이퍼를 용액 밖으로 서서히 끌어올리면 모세관 현상에 의해 IPA와 물이 따라 올라옴
물의 표면장력이 IPA 표면장력에 비해 크므로, IPA에서 물로 끌어당기는 힘이 발생
-> 웨이퍼 표면에 부착되어 있는 파티클의 제거도 가능, 물반점 없는 깨끗한 건조 가능
4. 새로운 개념의 세정
- 오존 세정: 과산화수소 사용을 대체하기 위한 새로운 습식 세정 기술
과산화수소를 대체해 환경적, 비용적 문제를 해결하기 위한 방법
과산화수소보다 강력한 산화제이며, 용액 내에서 분해되어 해로운 반응 생성물을 형성하지 않으며
사용량과 폐수를 절감 가능
-드라이 아이스 세정: 드라이아이스 미세 알갱이를 고압가스와 함께 분사시켜 작업물과 충돌시킴으로써 표면을 클리닝
반도체 웨이퍼 및 평판 디스플레이(FPD) 기판 등의 세정을 위한 세정방식
기존의 모래 혹은 세라믹 파우더를 고압 분사해 세정하는 블라스팅(Blasting)과 유사

- 아르곤 에어로졸 세정
아르곤과 질소의 혼합물을 진공 기화 냉각시켜 세정
- 레이저 세정
레이저 빔을 재료 표면에 조사해 표면 위의 오염물질 제거
오염물질을 증발시켜 제거

- 자외선(UV)세정

'반도체 > 반도체 제조 공정 장비 운영' 카테고리의 다른 글
| [STEP 한국기술대학] 반도체 제조 공정 장비 운영 - (11) Cleaning 공정 불량 분석 (0) | 2024.06.25 |
|---|---|
| [STEP 한국기술대학] 반도체 제조 공정 장비 운영 - (10) Cleaning 주요 모듈 (0) | 2024.06.25 |
| [STEP 한국기술대학] 반도체 제조 공정 장비 운영 - (8) Track 장비 유지 보수 방법 (0) | 2024.06.25 |
| [STEP 한국기술대학] 반도체 제조 공정 장비 운영 - (7) Track 장비에 의한 공정 불량 분석 (0) | 2024.06.25 |
| [STEP 한국기술대학] 반도체 제조 공정 장비 운영 - (6) Track 주요 모듈 (0) | 2024.06.24 |



