반도체 제조 공정 장비 운영
(15) CMP 장비에 의한 공정 불량 분석
CMP 공정의 평탄화
1. 평탄화(Planarization)의 분류
- 매끄러운 평탄화
- 일부분 평탄화
- 국부 평탄화
- 광역 평탄화
2. 비평탄화
단차를 가진 비평탄화된 상태

3. 매끄러운(smoothing) 평탄화
스텝 모서리가 둥글고 측벽이 기울어진 상태

4. 광역(Global) 평탄화
전체적인 스텝 높이가 균일화 되는 평탄화

CMP 이상발생 주요 변수
평탄도, 균일성, 연마속도, 패임&침식, 결함
1. 평탄도(Planarity)
- 층간 절연막 CMP 공정에서 중요한 평가지표
- 반도체 소자 내 세로가 주변회로 간의 광역적 단차 감소 정도로 표현
- 관계 공정 변수: 연마 패드의 탄성 변형성, 슬러리 공급의 균일성, 디바이스의 패턴 형상, 연마 압력 및 연마의 상대속도 등
2. 균일도(Sigma, %)
- 연마 후 웨이퍼 내, 롯(Lot) 내, 롯 별 잔류 막 두께의 편차로 정의함
- 공정 변수: 연마 압력의 분포, 연마 헤드의 형상 및 연마 플레이튼의 형상, 슬러리 공급의 균일성 등
3. 연마 속도(A/minn)
- 단위 시간당 제거되는 막의 두꼐로 정의
- 공정 변수: 연마 압력, 연마의 상대속도, 슬러리 내 연마 입자(Abrasive)의 크기와 함량, 슬러리 유량, 연마 헤드의 표면상태
4. 패임&침식 (Dishing&Erosion)
- STI CMP, Plug CMP 공정 후 회로 배선 내현상 정도로 정의
- 공정 변수: 연마되는 두 물질간의 연마 속도, 패드 특성, 슬러리 화약품에 의해 유발되는 미시적인 현상
(결함 및 소자의 전기적 특성 차이를 유발)
5. 결함(Defect)
- 연마 후 웨이퍼 표면에 잔류하는 입자 및 잔류성 물질에 의해 긁힘
- 역학적 공정에 의해 발생하는 현상
- 연마 후 습식 상태에서 웨이퍼를 세정할 수 있는 후 CMP 세정 시스템을 동반함
STI CMP 문제점

노란색이 절연막
두번째 그림이 가장 이상적이지만 Under Polishing 또는 Oxide Residue가 남는 등의 문제가 발생할 수 있음.
CMP Variation
- METAL CMP


Oxide 막까지 영향을 받아 꺼지는 등 문제가 발생.
주로 Errosion이 발생하는 곳에서 Dishing도 발생함
패턴 밀도
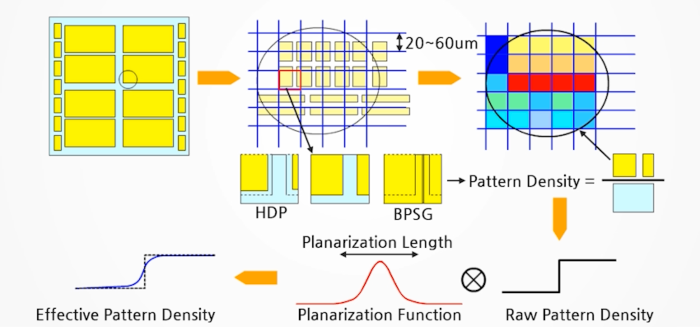
오염과 긁힘
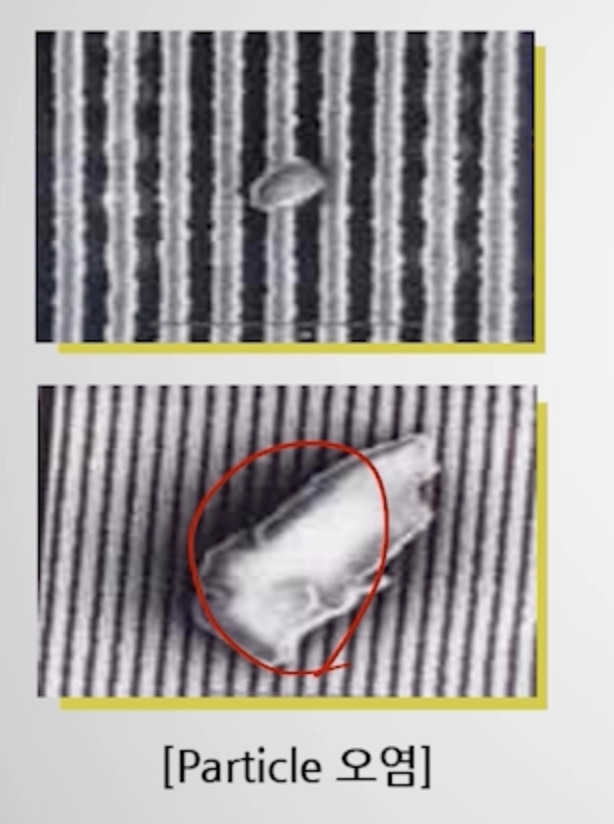
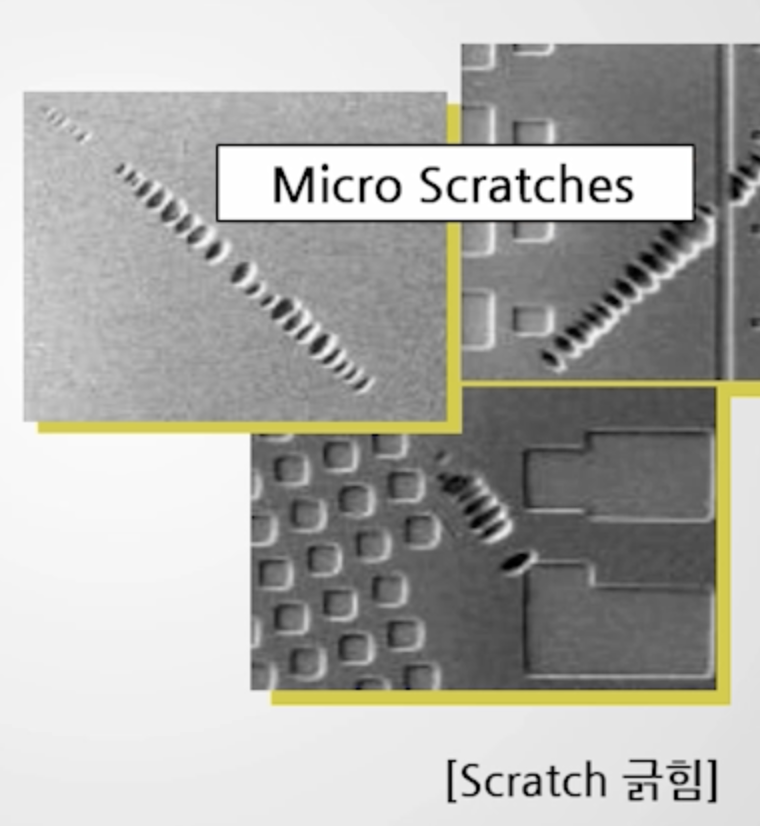
부산물로 인한 파티클 발생 -> 연마할때 스크래치 발생
'반도체 > 반도체 제조 공정 장비 운영' 카테고리의 다른 글
| [STEP 한국기술대학] 반도체 제조 공정 장비 운영 - (16) CMP 장비 유지 보수 방법 (0) | 2024.06.25 |
|---|---|
| [STEP 한국기술대학] 반도체 제조 공정 장비 운영 - (14) CMP 주요 모듈 (0) | 2024.06.25 |
| [STEP 한국기술대학] 반도체 제조 공정 장비 운영 - (13) CMP 주요 공정 (0) | 2024.06.25 |
| [STEP 한국기술대학] 반도체 제조 공정 장비 운영 - (12) Cleaning 장비 유지 보수 방법 (0) | 2024.06.25 |
| [STEP 한국기술대학] 반도체 제조 공정 장비 운영 - (11) Cleaning 공정 불량 분석 (0) | 2024.06.25 |