반도체 제조 공정 장비 운영
(14) CMP 주요 모듈
CMP 장비 시스템 구성
1. CMP 구성 모듈
연두색이 로더
노란색이 로봇


2. CMP 장비 구성
회전하면서 연마제인 slurry 공급
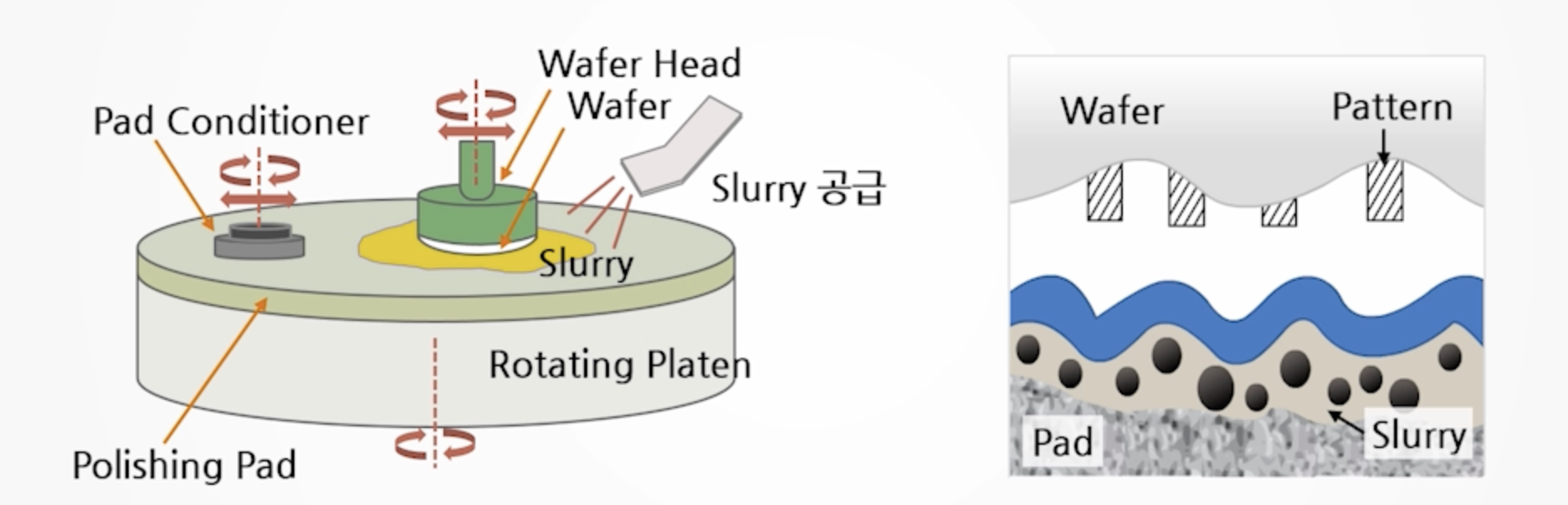
CMP 장비 구성품
1. 웨이퍼 헤드와 플레이튼

2. 슬러리: 산화막 연마제
- 알칼리 수용액의 작용
물 분자의 산화막 표면 침투, 수화작용으로 Si-O 결합력 약화, 실리카 입자 표면의 실리콘에 연결된 수산기(OH)기와
산화막 표면의 수산기가 결합, 실리콘 표면의 Si-OH 결합, 실리카 입자의 물리적 마찰에 의해 산화막 표면의 Si-OH결합
, 실리카 입자의 물리적 마찰에 의해 산화막 표면의 Si-OH 결합이 이탈, 산화막 표면 제거
- 산화막용 연마액 : pH 10~12정도의 염기성인 KOH
- 연마제: 실리카 또는 세리아 계열을 주로 사용함 -> 전통적으로 유리 렌즈 가공에 많이 사용
3. 슬러리: 금속막 연마제
- 금속막용 슬러리
희석된 산화제에 연마제가 분사됨
- 금속막 연마 모델: Kaufuman Model
산화제가 금속막 표면을 산화함, 산화된 금속막 표면을 연마제의 물리적 마찰에 의해 반복 제거 연마 진행
- 연마 대상 금속막: 텅스텐, 구리, 알루미늄
4. 패드: 폴리우레탄

5. 패드 컨디셔너: 다이아몬드 디스크로 패드를 문질러 연마

'반도체 > 반도체 제조 공정 장비 운영' 카테고리의 다른 글
| [STEP 한국기술대학] 반도체 제조 공정 장비 운영 - (16) CMP 장비 유지 보수 방법 (0) | 2024.06.25 |
|---|---|
| [STEP 한국기술대학] 반도체 제조 공정 장비 운영 - (15) CMP 장비에 의한 공정 불량 분석 (0) | 2024.06.25 |
| [STEP 한국기술대학] 반도체 제조 공정 장비 운영 - (13) CMP 주요 공정 (0) | 2024.06.25 |
| [STEP 한국기술대학] 반도체 제조 공정 장비 운영 - (12) Cleaning 장비 유지 보수 방법 (0) | 2024.06.25 |
| [STEP 한국기술대학] 반도체 제조 공정 장비 운영 - (11) Cleaning 공정 불량 분석 (0) | 2024.06.25 |