반도체 공정에서 발생하는 Defect
Defect의 종류
Random
공정 환경 내 부유 먼지에 의해 발생하는 Defect
random한 위치에 떨어지고 wafer 전면에 골고루 분포하는 특징
Systematic
설비에서 발생하는 특정한 문제로 인해 먼지 또는 공정 parameter
뒤틀림에 의한 불량, random defect와 경계가 모호함
Paramatric
공정 set-up의 문제 또는 설비에서 특정한 문제 발생으로 인해
설계한 전기적 특성에서 벗어나는 불량
systematic 불량과 마찬가지로 문제의 발생 원인에 따라 형태가 다르게 나타남
Defect 점검 도구 (Defect Inspection tool)
Laser Scattering Inspection (dark field)
- WF에 레이저를 조사해 scattering된 beam의 signal을 비교해 defect 검출
Image Processing Inspection (Bright field)
- WF에서 반사되어 나오는 빛을 TDI sensor에 맺히게 한 후 gray level 차에 의해 검출

E-beam Inspection
- 주사된 electron이 WF 표면에서 반사되는 2차 전자를 defect해 charging양 차로 검출

FCC
Fail Chip count로,
fab의 inspection tool 검사 결과로 Defect 수준을 가늠해보는 index

defect 원인 분석
SBS(step by step)분석
- 검출하고자 하는 step의 Defect 분석을 위해 이전 공정의 defect는 배제해야 함
DSA(defect source analysis)
- sbs검사한 WF간의 전 step, 후 step성 불량을 defect address로 자동 분류하는 시스템
FIB(Focuses Ion Beam)
- Ion Gun을 이용해 극소 부분 밀링을 통해 단면 촬영을 하는 장비
- vertical 분석을 통해 Defect source 규명에 활용
EDX(Energe dispersive X-ray) in fab
- 각 원소가 가지는 특성 x-ray energy 대역에서의 peak를 통해 해당 시료의 성분을 분석하는 장비
TEM 분석
- 고해상도로 실제 이미지와 성분을 직접 볼 수 있지만 시간이 많이 걸리고
WF를 절단 사용 해야 하기 때문에 기회 비용이 크게 들어감
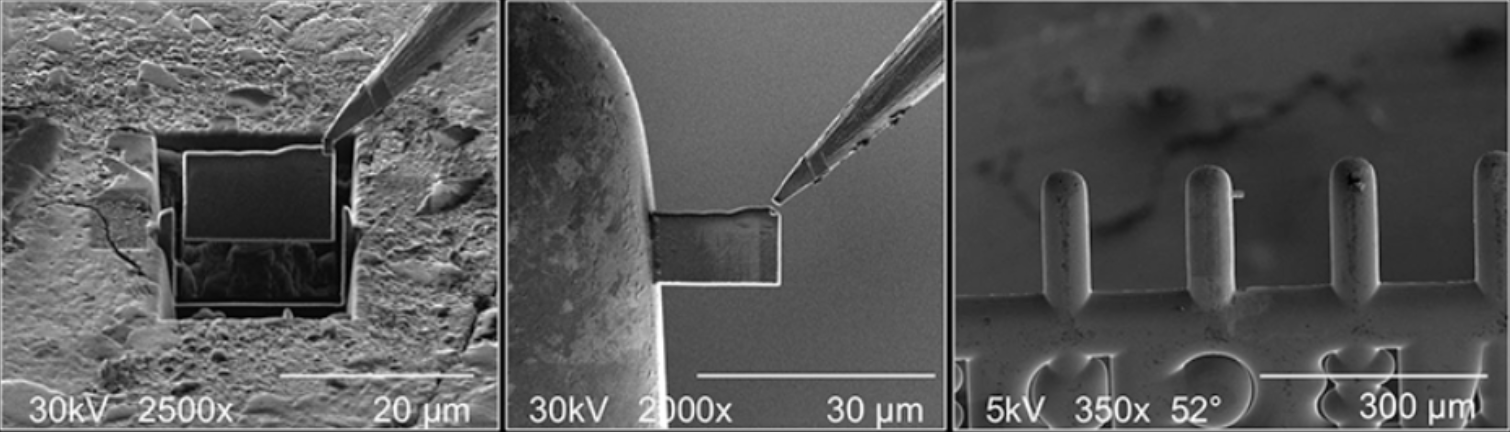
Edge 분석
- Edge Monitoring (Visedge, Circle tool)
: WF 표면에 레이저빔을 입사시키면 표면에 따라 specular, phase, scatter 3가지
channel에서 defect detecting
- Defect Detecting
: Edge는 Non-pattern 이기 때문에 Reference가 존재하지 않음.
따라서 기존 data를 바탕으로 특성화된 signal로 Defect 판별
- BBT(불발통) : 불량발생통보의 약자
: defect 검사 진행 후 control limit over시 warning report 발의를 통한
유관 부서 feedback 및 설비 조치를 통한 불량 개선 및 수율, 품질 향상을 목적으로 함
-> 한 건의 defect 불발통도 Excursion(공정이탈) 발생으로 간주하고 품질과 수율 attack을 제어하며
excursion zero화를 실현하기 위해 노력해야 함
-> 불발통 발의 - lot / 설비 hold - 불량 발생 원인 규명 - 불량 개선 및 close
불량 chip 분석
EFA (Electrical Failure Analysis)
- 불량 chip의 전기적 test및 결과 해석 / 고장현상(symptom)을 define / 고장위치를 localization /
후속 PFA(Physical Failure Analysis)를 통한 defect 규명을 가능하도록 하는 업무
Nonoprobing
- nanoscale tungsten wire를 이용해서 소자의 전기적인 파라미터를 추출하는 방법
수율, 품질, 신뢰성을 향상하는 분석 방법
- 진공에서 SEM(Scanning Electron Microscope) 방식,
대기에서 AFM(Atomic Force Microscope) 방식 사용 (서로 상호 보완적인 방식)
MTS(module target specification)
- 직접 측정이며,
TEM(Transmission Electron Microscope 고전압 가속 전자 빔을 활용한 투과전자현미경) 분석을 사용
- 수율 및 제품 성능에 영향을 주는 인자 (CD, Thickness, height, angle, 조성, 성분)들이 요구된
target 및 spec, limit의 요구 필요조건을 만족하는지 여부 확인
참고 출처
반도체 Defect, 불량 분석 방법
※ Defect의 종류 Random 공정을 진행하는 환경 안에서 떠다니는 먼지에 의해 발생하는 defect ramdom한 ...
blog.naver.com